WOW联盟研发三维大规模集成技术的举措介绍
图研参与了以东京工业大学科学技术创成研究院大场隆之特聘教授为核心,致力于新一代半导体研发的产学研究平台“WOW联盟”,联合研发独创的三维大规模集成技术。
可以说目前的半导体研发在通过微细化来提高性能方面已达到技术界限,人们对于纵向堆叠安装芯片的三维安装技术表现出了愈发高涨的期待。而在通过三维集成来实现高性能的同时,还提出了抑制功耗及减少热阻的要求,为了解决此类课题,WOW联盟一直致力于研发新的小芯片(Chiplet)集成技术。
通过将晶片自传统的20~30μm超薄化为4μm的独创“晶片薄化技术”、不使用凸块实施TSV配线的“无凸块配线技术”、由高密度大规模并行配线实现的“太字节高带宽传送”应用于WOW(Wafer on Wafer)及COW(Chip on Wafer)的堆叠中,WOW联盟建立了三维大规模集成技术“BBCube”。而且,通过发展此项技术,将半导体系统微型化为千分之一,对于功耗的研发工作则还在继续,旨在使其达到千分之一以下。
在其三维集成电路的安装设计中,图研运用多板设计环境“CR-8000 Design Force”援助技术研发。
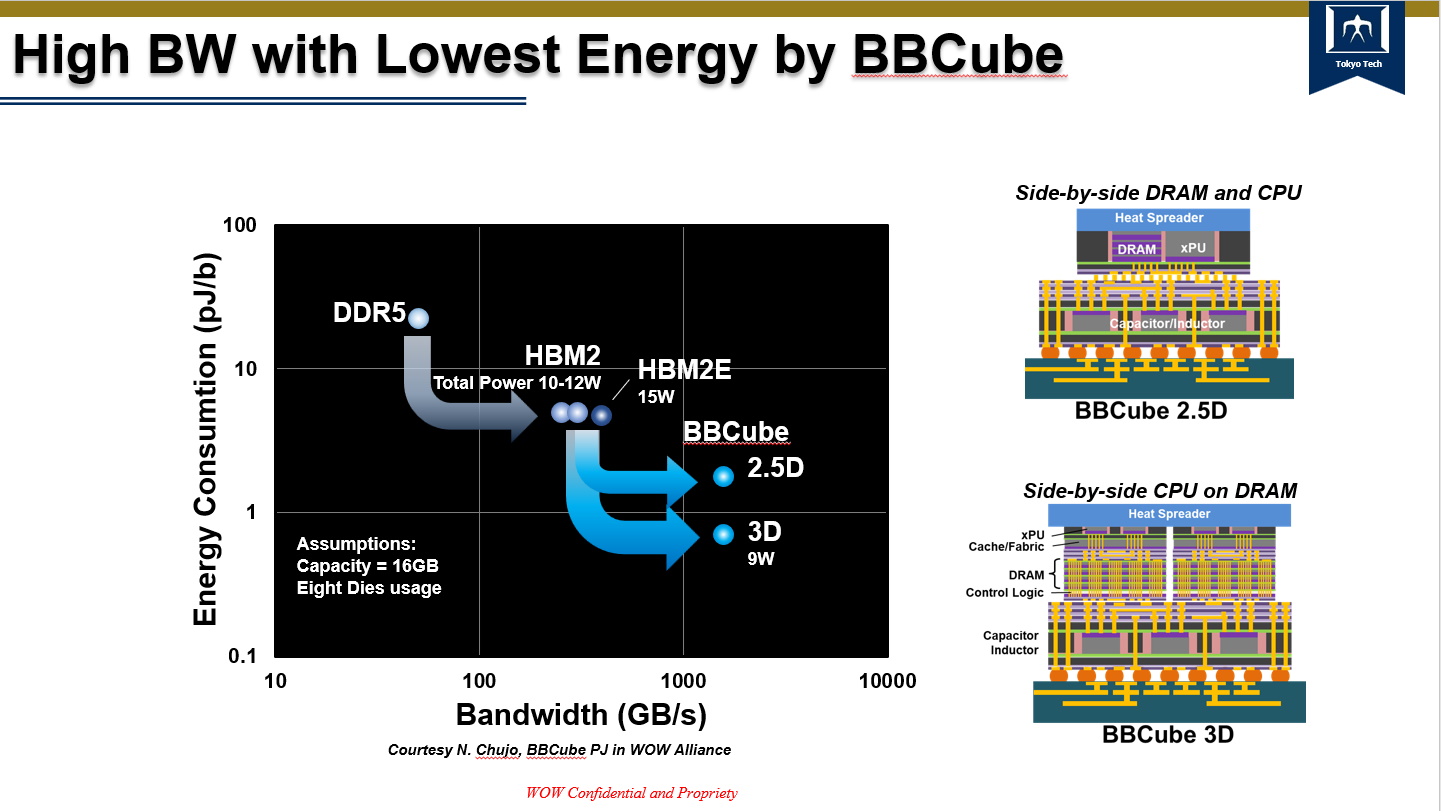 |
 |